顶圣集团与您分享行业最新资讯
一、关于“锡珠”形态及标准
标准一:MIL-STD-2000中的“不允许有锡珠”;
标准二:IPC-A-610C中的“每平方英寸少于5个”。
在IPC-A-610C标准中,规定最小绝缘间隙0.13毫米,直径在此之内的锡珠被认为是合格的;而直径大于或等于0.13毫米的锡珠是不合格的,制造商必须采取纠正措施,避免这种现象发生。
常见锡珠形态及其尺寸照片见下图:
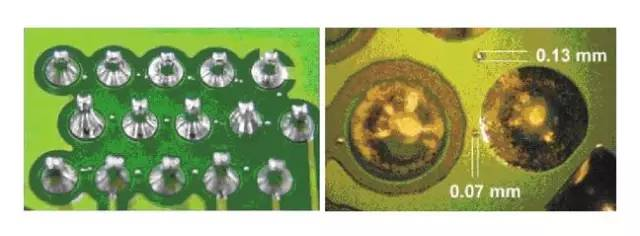
二、“锡珠”原因及预防措施
在“SMT表面贴装”焊接制程中,回流焊的“温度、时间、焊膏质量、印刷厚度、钢网(模板)制作、装贴压力”等因素都有可能造成“锡珠”的产生。
(一)、产生“锡珠”原因一:焊膏质量
1,焊膏中的金属含量。
焊膏中金属含量的质量比约为89%-91%,体积比约为50%左右。通常金属含量越多,焊膏中的金属粉末排列越紧密,锡粉的颗料之间有更多机会结合而不易在气化时被吹散,因此不易形成“锡珠”;如果金属含量减少,则出现“锡珠”的机率增高。
2,焊膏中氧化物的含量。
焊膏中氧化物含量也影响着焊接效果,氧化物含量越高,金属粉末熔化后在与焊盘熔合的过程中表面张力就越大,而且在“回流焊接段”,金属粉末表面氧化物的含量还会增高,这就不利于熔融焊料的完全“润湿”从而导致细小锡珠产生。
3,焊膏中金属粉末的粒度。
焊膏中金属粉末是极细小的近圆型球体,常用的焊粉球径约在25-45μm之间,较细的粉末中氧化物含量较低,因而会使“锡珠”现象得到缓解。
4,焊膏抗热坍塌效果。
在回流焊预热段,如果焊膏抗热坍塌效果不好,在焊接温度前(焊料开始熔融前)已印刷成型的焊膏开始坍塌,并有些焊膏流到焊盘以外,当进入焊接区时,焊料开始熔融,因为内应力的作用,焊膏收缩成焊点并开始浸润爬升至焊接端头,有时因为焊剂缺失或其他原因导致焊膏应力不足,有一少部分焊盘外的焊膏没有收缩回来,当其完全熔化后就形成了“锡珠”。
(二)、产生“锡珠”原因二:使用不当
1,“锡珠”在通过回流焊炉时产生的。
流焊过程分为“预热、保温、焊接和冷却”四个阶段。“预热段”是为了使印制板和表贴元件缓慢升温到120℃-150℃之间,这样可以除去焊锡膏中易挥发的溶剂,减少对元件的热冲击。而在这一过程中焊膏内部会发生气化现象,这时如果焊膏中金属粉末之间的粘结力小于焊剂气化产生的力,就会有少量“焊粉”从焊盘上流下或飞出,在“焊接”阶段,这部分“焊粉”也会熔化,从而形成“锡珠”。由此可以得出这样的结论“预热温度越高,预热速度越快,就会加剧焊剂的气化现象从而引起坍塌或飞溅,形成锡珠”。因此,我们可以采取较适中的预热温度和预热速度来控制“锡珠”的形成。
2,焊膏在印制板上的印刷厚度及印刷量。
焊膏的印刷厚度是生产中一个主要参数,印刷厚度通常在0.15-0.20mm之间,过厚或过多就容易导致“坍塌”从而形成“锡珠”。在制作钢网(模板)时,焊盘的大小决定着模板开孔的大小,通常,我们为了避免焊膏印刷过量,将印刷孔的尺寸控制在约小于相应焊盘接触面积10%,结果表明这样会使“锡珠”现象有一定程度的减轻。
3,如果在贴片过程中贴装压力过大,当元件压在焊膏上时,就可能有一部分焊膏被挤在元件下面或有少量锡粉飞出去,在焊接段这部分焊粉熔化从而形成“锡珠”;因此,在贴装时应选择适当的贴装压力。
4,焊膏通常需要冷藏,在使用前一定要使其恢复至室温方可打开包装使用,如果焊膏温度过低就被打开包装,会使膏体表面产生水分,这些水分在经过预热时会造成焊粉飞出,在焊接段会让热熔的焊料飞溅从而形成“锡珠”。我国一般地区夏天的空气湿度较大,把焊膏从冷藏取出时,一般要在室温下回温4-5小时再开启瓶盖。
5,生产或工作环境也影响“锡珠”的形成,当印制板在潮湿的库房存放过久,在装印制板的包装袋中发现细小的水珠,这些水分和焊膏吸潮的水分一样,会影响焊接效果从而形成“锡珠”。因此,如果有条件,在贴装前将印制板或元器件进行一定的烘干,然后进行印刷及焊接,能够有效地抑制“锡珠”的形成。
6,焊膏与空气接触的时间越短越好,这也是使用焊膏的一个原则。取出一部分焊膏后,立即盖好盖子,特别是里面的盖子一定要向下压紧,将盖子与焊膏之间空气挤出,否则对焊膏的寿命会有一定的影响,同时会造成焊膏的干燥加快或在下次再使用时吸潮,从而形成“锡珠”。
(三)、“锡珠”预防与控制
1,焊膏的选用
在选择焊膏时,应坚持在现有工艺条件下的试用,这样,既能验证供应商焊膏对自身产品、工艺的适用性,也能初步了解该焊膏在实际使用中的具体表现。对焊膏方面的评估,应注意各种常见的参数,比如“焊油与焊粉的比例、锡球的颗粒度”等。
2,“SMT表面贴装”工艺控制与改进
(1),严格按照供应商提供的存贮条件及温度进行存贮,一般情况下焊膏应存贮于0-10℃的冷藏条件下;
(2),焊膏取出后、使用前,应该进行常温下的回温,在焊膏未完全回温前,不得开启;
(3),在搅拌过程中,应该按照供应商所提供的搅拌方法及搅拌时间进行搅拌;
(4),在印刷过种中,应该注意印刷的力度,及钢网表面的清洁度,及时擦拭钢网表面多余的焊膏残留,防止在这个过程污染PCB板面从而造成焊接过程中的锡珠产生;
(5),回流焊过程中,应严格按照已经订好的回流焊曲线进行作业,不得随意调整;同时应该经常校验回流焊曲线与标准曲线的差异并修正;
(6),在“SMT表面贴装”工艺中,钢网(模板)的“开口方式”以及“开口率”很可能导致焊膏在“印刷特性”及“焊接特性”方面的一些缺陷从而引起“锡珠”。